Looking for help?
-
PVD纳米涂层
-
行业知识
-
工业品市场营销
-
展会及论坛
-
内部交流区
目录
< 所有主题
Print
气相沉积工艺的真空镀膜设备种类
Posted
Updated
By木易·灵兮
目录
气相沉积分为化学气相沉积(CVD)和物理气相沉积( PVD 21%)两大类,以及兼有两种工艺特点的等离子化学气相沉积法PeCVD(31%),和CVD变形工艺原子沉积技术ALD(13%)。
| PVD镀膜设备 | 真空蒸镀 EPVD | |
| 离子镀 PaPVD | 电弧离子镀 | |
| (纳狮 磁控溅射离子镀) | ||
| 溅射镀 SPVD | 磁控溅射镀 | |
| HiPIMS(高功率脉冲磁控溅射) | ||
| CVD镀膜设备 | 常压CVD-NPCVD | |
| 低压CVD-LPCVD | ||
| 激光CVD-LCVD | ||
| 金属有机化合物CVD-MOCVD | ||
| PeCVD镀膜设备 | ||
| ALD原子沉积设备 |
ALD、PVD与CVD真空镀膜工艺特点比较
对于有纳米级别膜厚需求而言,原子层沉积除了其沉积速率较慢外,其他优点是传统的PVD和CVD技术所无可比拟的。对于不断缩微化的硅集成电路材料,其使用材料的几何厚度已低达1nm,这时沉积速率慢的缺点就不再是主要矛盾,而精确的薄膜厚度和成分控制、优秀的表面覆盖率和沉积均匀性更重要。
| (原子层沉积)ALD | (物理气相沉积)PVD | (化学气相沉积)CVD | |
| 沉积原理 | 表面反应-沉积 | 蒸发-凝固 | 气相反应-沉积 |
| 沉积过程 | 层状生长 | 形核长大 | 形核长大 |
| 台阶覆盖率 | 优秀 | 一般 | 好 |
| 沉积速率 | 慢 | 快 | 快 |
| 沉积温度 | 低 | 低 | 高 |
| 沉积层均匀性 | 优秀 | 一般 | 较好 |
| 厚度控制 | 反应循环次数 | 沉积时间 | 沉积时间,气相分压 |
| 成分 | 均匀,杂质少 | 无杂质 | 易含杂质,夹杂 |
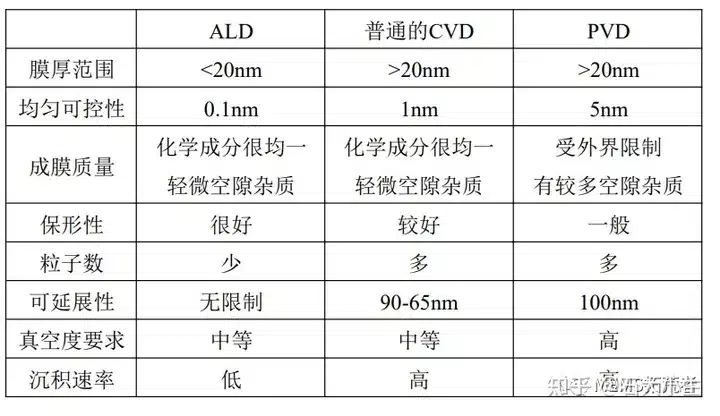

PVD与CVD工艺比较

几种CVD设备的主要技术规格

